【Discontinued Product】High-Speed & High-Accuracy Flip Chip Bonder YSB55w Feature
High bonding accuracy and x3 productivity of conventional machines! This brings a New Era in Semiconductor packaging for the expanding flip chip market.
Bonding process

High-Speed 8-die simultaneous pickup & simultaneous transfer achieve 13,000 UPH
Dual bonding heads Multi-nozzle (8 nozzles per head)

Two 8-nozzle heads with compact design enable high precision force control and also support thin die processing.
Dual flip heads

Achieves high-speed pick-up by parallel processing with 2 flip heads.
Multi-die supply

Equipped with 2 supply units for each flip head unit. Feeds flip chips with no time loss!
High-Accuracy ±5μm (3σ)
High rigidity frame & beam

Meticulous structural analysis and test verification achieve both high-level accel-decel drive and high-precision.
Linear motor/driver designed in-house

Unique dedicated design gives high-speed along with superb positioning accuracy.
High resolution chip recognition camera

Missing bump check and precise position alignment using bump positions.
Maintaining high placement accuracy
Our in-house developed MACS (Multiple Accuracy Compensation System) has been upgraded and now achieves bonding accuracy ±5μm (3σ). Original heat analysis & heat compensating algorithm realizes consistent placement accuracy.
High-Quality & Flexibility
Newly developed dipping station

Tool-less/skill-less flux thickness setting saves product change-over time drastically.
Nozzle station (ANC : Auto Nozzle Change)

Auto nozzle changer handles chip size range from □2 to 30mm minimizing product change-over time.
Wafer feed unit
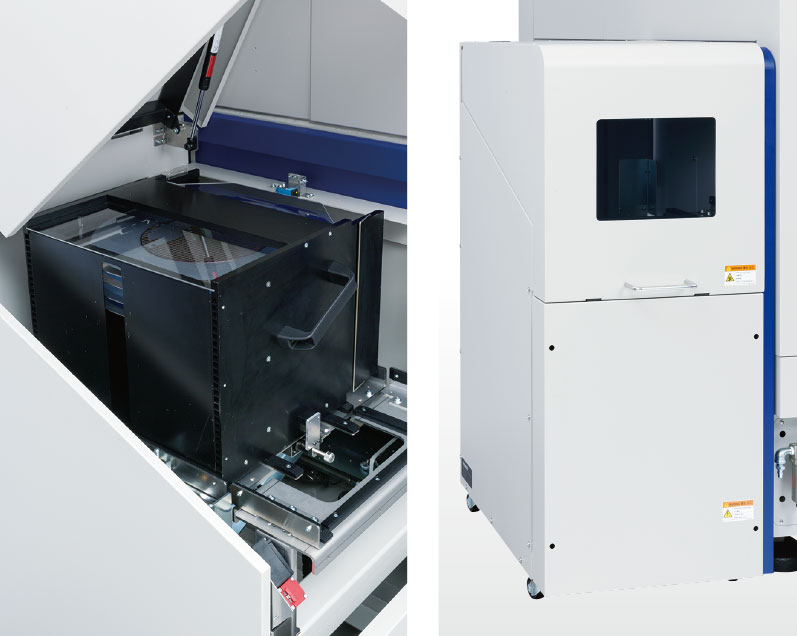
Wafer feeder with wafer expander & theta alignment mechanism as standard feature.

